介紹用於長時間曝光成像的先進解決方案:解決熱雜訊和熱畫素問題
長時間曝光成像在檢測細微缺陷時,是十分重要的技術,例如檢查顯示器壞點,或在弱光下進行半導體的微弱訊號檢測。但是,較長的曝光時間通常會帶來熱點等挑戰。

以較長的曝光時間拍下所有細節
顯示器和半導體檢測的精確度十分重要,每一個微小的細節都是關鍵。檢測顯示器時,經常使用長時間曝光來檢測低亮度缺陷和色彩均勻性變化。而在半導體檢測中,雖然縮短曝光時間可以提高資料產出量,但當照明亮度太低而無法產生與足以和雜訊區分開來的訊號時,長時間曝光就顯得特別重要。
半導體與顯示器檢測長時間曝光成像的主要挑戰
較長的曝光時間會帶來挑戰,例如熱雜訊的增加、熱畫素、暗電流和運動偽影;這些問題會降低 影像品質 並不利於檢測精度。
熱雜訊和熱點:
較長的曝光時間會導致感光元件發生熱量積聚,產生熱雜訊和看起來很像產品缺陷的熱畫素,因而導致誤報和代價高昂的重工。
影像細節損失:
機械偏移、環境振動或熱膨脹造成的運動偽影,會使高放大倍率的半導體成像,以及高解析度顯示器分析中的精細細節變得模糊不清。
訊噪比 (SNR) 的取捨:
雖然較長的曝光時間能夠捕捉到更多光子,SNR 得以提高,但也會放大熱畫素和暗電流雜訊,造成高解析度感光元件中的關鍵缺陷遭到掩蓋。
成本與影像品質:
具有冷卻功能最佳化的高階感光元件可將雜訊降低到最少,但卻造成成本和複雜性的增加,因此不適合預算敏感型應用。
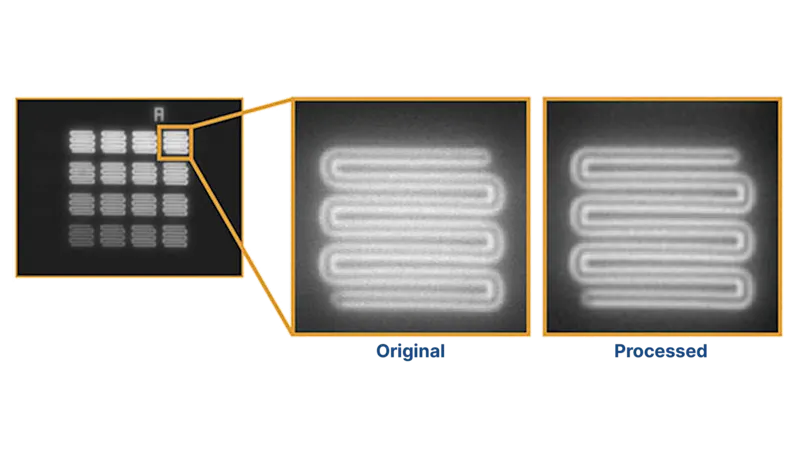
各種熱雜訊和熱畫素解決方法
為了克服這些挑戰,感光元件最佳化、冷卻解決方案和先進影像處理技術的組合,有助於在不犧牲效率的情況下保持精度。
方法 | 運作方式 | 優點 | 缺點 |
|---|---|---|---|
熱畫素校正 | 辨識並校正多張畫面上的熱點畫素。 | 直接針對熱畫素,維持訊號正確性。 | 對即時應用來說,運算成本較高。 |
傳統的暗畫面消去法 | 拍攝較暗的參考影像,減去影像中的熱雜訊。 | 對於靜態雜訊圖樣有效。 | 需要兩張畫面,並且無法處理時變雜訊。 |
畫素對應與遮罩 | 辨識熱畫素並將其替換為相鄰畫素值。 | 對持續性的熱畫素有效。 | 對真正的缺陷圖樣會造成失真。 |
時序雜訊降噪 (畫面堆疊) | 將多個畫面進行平均運算,以降低隨機雜訊 | 提高 SNR,適用於靜態雜訊。 | 不適用於移動物體或動態場景。 |
相機外殼設計最佳化 | 降低感光元件溫度,以防產生熱雜訊與熱畫素。 | 自來源防止熱畫素,提高影像品質。 | 無法消除所有噪點,特別是在極長時間曝光時。 |
最佳方法:綜合解決方案
為了獲得最佳影像結果,尤其是在半導體和顯示器檢測等複雜環境中,幾乎沒有單一標準解決方案可以解決所有問題。因此,建議使用綜合方法,如硬體解決方案和後製處理演算法的結合。

硬體最佳化:精心設計的相機外殼,可將感光元件維持在穩定的低溫下,顯著減少熱雜訊和熱畫素的產生。將相機核心溫度保持在 45°C 以下特別有效,可將熱畫素抑制在最低水準。
軟體後製處理: 拍攝後,使用熱點相關性、暗畫面消去法和畫素映射等演算法,可以進行影像最佳化,校正因長時間曝光而導致的任何殘留偽影。
以 FPGA 進行即時降噪: 使用 FPGA 進行處理的先進解決方案,可以動態調整曝光設定,並直接在感光元件層級來執行即時雜訊校正,確保在不增加處理延遲的情況下,將雜訊和熱點降至最低限度。
沒有單一固定的解決方案——它必須適應不斷變化的應用需求。我們的工作是徹底了解應用,並迅速找到成本和性能之間的最佳平衡。在我們的實驗室中,我們將解決方案推向極限,當我們提供一張 15 分鐘曝光的測試影像時,客戶對結果感到非常滿意。
成果:將長時間曝光成像性能提高到極限
我們提供先進的半導體和顯示器檢測解決方案,可有效對應長時間曝光成像帶來的諸多挑戰。
減少熱畫素:我們的動態熱點校正演算法,可在 8 秒的曝光時間內,將熱點保持在 2 ppm (每百萬畫素) 以下,增益設定為 27dB,確保缺陷檢測畫面更為清晰。
即時處理 CPU 零負載: 直接在相機的 FPGA 上執行多種影像處理演算法,無需透過 PC 執行,電腦 CPU 零負載也可獲得高品質結果,同時提高效率。
曝光設定最佳化: 無論是動態顯示器檢測還是高精度半導體分析,我們都能提供最佳化曝光設定,以滿足您的檢測需求。
精巧高效的冷卻解決方案:我們提供可選用的冷卻設計,從頭開始防止熱點產生;該設計可以取代後製處理的人力,還能獲得更佳成果。

透過 Basler 的整合式動態解決方案,您可以獲得卓越的成像性能、更高的檢測精度、不受影像的處理速度與高成本效益,獲得最佳成果。
測試或試用 - 聯絡我們的工程師此方案所用產品
想實施類似的方案嗎?這些產品能有所助益。



